您是否有因異質材料間熱膨脹係數的差異,在熱脹冷縮所引起的熱應力而造成破裂的經驗?又或者發生翹曲Warpage的問題? 那就應該試著去降低配方的CTE值!!
公隆化學提供各種高品質的球形二氧化矽材料(奈米/亞微米/微米),經實證可達高填充率,增加機械強度及降低配方的熱膨脹係數。

物體由於温度改變而有脹縮現象。其變化能力以等壓(P一定)下,單位温度變化所導致的長度量值的變化,即熱膨脹係數(CTE) α表示。各物體的熱膨脹係數不同,大多數情況之下,此係數為正值。也就是説温度變化與長度變化成正比,温度升高體積擴大。
而當兩個異質材料結合時,若CTE值相差過大,即會產生破裂及翹曲的問題,如下圖所示:
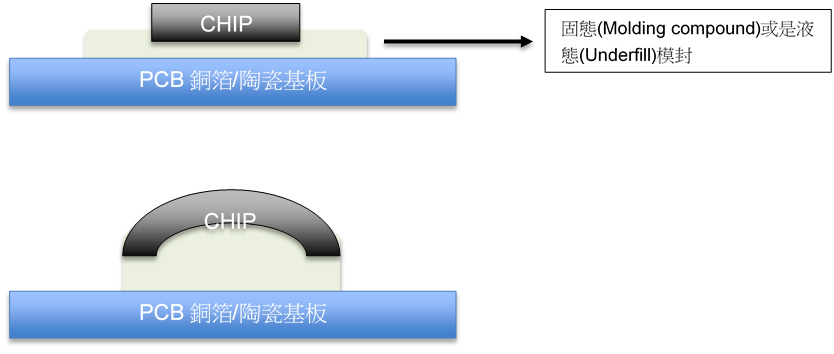
舉半導體封裝材料來說,覆晶封裝主要是使用底部填充膠Underfill,底部填充膠Underfill成分以環氧樹脂混合高含量無機粉體二氧化矽為主。由於環氧樹脂本身的熱膨脹係數(CTE)相當高,為了使液態封裝材料的熱膨脹係數能夠接近晶片和基板的熱膨脹係數,利用二氧化矽本身具有相當低的熱膨脹係數,加入高比例的二氧化矽粉體對於液態封裝材料熱膨脹係數的降低有相當顯著的效果,避免因為CTE的差異而有破碎或翹曲的問題發生。除此之外,二氧化矽粉體亦具備低介電損耗以及增加機械強度等特性。
|
材料 |
CTE值(ppm/ ˚C) |
|
環氧樹脂 |
50-100 |
|
矽晶片 |
3 |
|
陶瓷基板 |
15-20 |
|
二氧化矽 |
0.5 |
因應半導體封裝朝向多層及窄間距發展,底部填充膠Underfill所用的粉體粒徑勢必變得更小,但奈米或亞微米等級的二氧化矽,容易有團聚使分散難度提高的問題,故對粉體做表面改質是各家廠商關鍵的技術所在;球形粉體則具有高流動性及低比表面積的特性,會是需要高流動性的液態封裝材料主要首選。
封裝技術進入5G高頻與異質整合的新挑戰,台灣屬半導體的封裝大國,但長期以來仰賴國外之進口封裝材料,故本土廠商研發低介電常數、低介電損失、與低熱膨脹係數的封裝材料做到在地化生產將是不變的大趨勢。
除了底部填充膠Underfill外,亦有相當多的半導體材料會需要利用奈米/微米球形二氧化矽去降低CTE值,例如:半導體元件封裝用熱壓非導電膠NCP、固態模封材料EMC、非導電底部填充薄膜NCF、ABF增層薄膜、抗蝕刻油墨、銅箔基板CCL等等…,由此可見一個好的二氧化矽材料選擇,可以將產品等級提升到更高的層次。
(延伸閱讀:二氧化矽,奈米等級球形結構,是半導體封裝、銅箔基板填料的最佳選擇!!)
#球形二氧化矽 #低熱膨脹係數 #高填充率 #流動性佳 #電子封裝填料 #低介電常數
#Epoxy Molding Compound #Molding Underfill #Thermal Interface Material #Underfill底部填充膠#CCL #非導電底部填充薄膜NCF#ABF增層薄膜#半導體元件封裝用熱壓非導電膠NCP#固態模封材料EMC
.png)
.png)

